客户是专注于物联网产品及服务,提供从模块,设备,APP开发,云乃至大数据分析的整体解决方案及产品服务
主要产品有蓝牙模组,智能家居,智能硬件。其中蓝牙模组用到我公司底部填充胶水

客户的产品是蓝牙模组
客户产品用胶部位;蓝牙模组BGA芯片需要填充包封.

客户需要解决的问题:为了保护焊点不受环境影响和振动影响,蓝牙模组BGA芯片需要点胶填充包封。
客户对胶水测试要求:
1,做填充效果检验,
2,做相关可靠性测试
汉思新材料推荐用胶
已推荐HS703底部填充胶给客户测试.我司技术人员带填充胶水和手动点胶机去客户现场测试.
客户对试样结果和配合表示满意.后续进行小批量生产.
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表德赢Vwin官网 网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
- 芯片
+关注
关注
450文章
49392浏览量
416098 - 芯片封装
+关注
关注
11文章
445浏览量
30364 - 蓝牙模组
+关注
关注
0文章
39浏览量
4019
发布评论请先登录
相关推荐
底部填充工艺在倒装芯片上的应用
底部
填充工艺在倒装
芯片(FlipChip)上的应用是一种重要的封装技术,旨在提高封装的可靠性和延长电子产品的使用寿命。以下是该工艺的主要应用和优势:增强可靠性:倒装
芯片封装中的焊点(常

详解点胶工艺用途和具体要求
电子产品
芯片的微型化正变得越来越受欢迎。但是微型化带来了焊点可靠性问题。元件和基板使用锡膏进行焊接,但是由于体积太小使得焊点更容易受到应力影响而出现脱落问题。因此引入了
底部
填充工艺。该工艺通过点
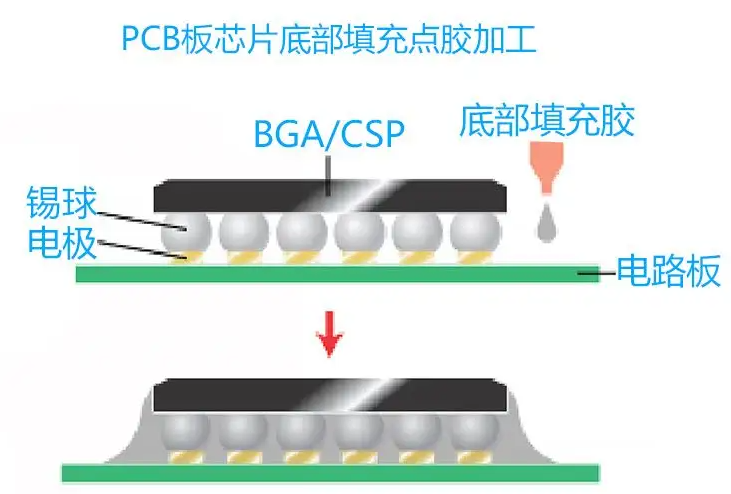
“专精特新”点亮中国制造,汉思新材料自主研发生产芯片封装胶
“专精特新”点亮中国制造,汉思新材料自主研发生产
芯片封装
胶汉思新材料近15年来始终秉持“专业专注专心”的创业初心,做好产品、办好企业。以公司研发投产的新产品
芯片封装
底部





 蓝牙模组BGA芯片底部填充胶应用
蓝牙模组BGA芯片底部填充胶应用

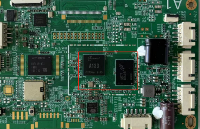



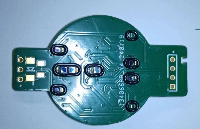



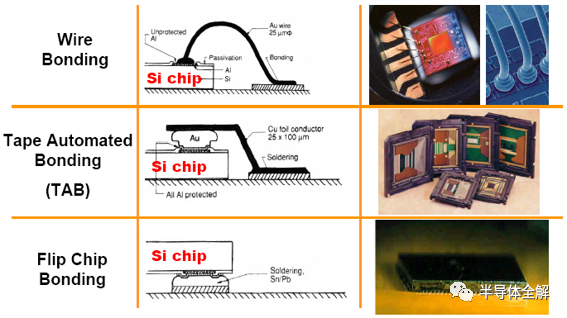











评论